- 反应离子腐蚀技术

反应离子腐蚀技术
工作原理
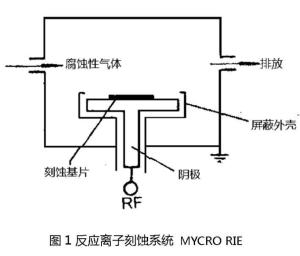 图1是反应离子刻蚀系统原理图。通常情况下,反应离子刻蚀机的整个真空壁接地, 作为阳极, 阴极是功率电极, 阴极侧面的接地屏蔽罩可防止功率电极受到溅射。要腐蚀的基片放在功率电极上。腐蚀气体按照一定的工作压力和搭配比例充满整个反应室。对反应腔中的腐蚀气体, 加上大于气体击穿临界值的高频电场, 在强电场作用下, 被高频电场加速的杂散电子与气体分子或原子进行随机碰撞, 当电子能量大到一定程度时, 随机碰撞变为非弹性碰撞, 产生二次电子发射, 它们又进一步与气体分子碰撞, 不断激发或电离气体分子。这种激烈碰撞引起电离和复合。当电子的产生和消失过程达到平衡时, 放电能继续不断地维持下去。由非弹性碰撞产生的离子、电子及及游离基(游离态的原子、分子或原子团) 也称为等离子体, 具有很强的化学活性, 可与被刻蚀样品表面的原子起化学反应, 形成挥发性物质, 达到腐蚀样品表层的目的。同时, 由于阴极附近的电场方向垂直于阴极表面, 高能离子在一定的工作压力下, 垂直地射向样品表面, 进行物理轰击, 使得反应离子刻蚀具有很好的各向异性。
图1是反应离子刻蚀系统原理图。通常情况下,反应离子刻蚀机的整个真空壁接地, 作为阳极, 阴极是功率电极, 阴极侧面的接地屏蔽罩可防止功率电极受到溅射。要腐蚀的基片放在功率电极上。腐蚀气体按照一定的工作压力和搭配比例充满整个反应室。对反应腔中的腐蚀气体, 加上大于气体击穿临界值的高频电场, 在强电场作用下, 被高频电场加速的杂散电子与气体分子或原子进行随机碰撞, 当电子能量大到一定程度时, 随机碰撞变为非弹性碰撞, 产生二次电子发射, 它们又进一步与气体分子碰撞, 不断激发或电离气体分子。这种激烈碰撞引起电离和复合。当电子的产生和消失过程达到平衡时, 放电能继续不断地维持下去。由非弹性碰撞产生的离子、电子及及游离基(游离态的原子、分子或原子团) 也称为等离子体, 具有很强的化学活性, 可与被刻蚀样品表面的原子起化学反应, 形成挥发性物质, 达到腐蚀样品表层的目的。同时, 由于阴极附近的电场方向垂直于阴极表面, 高能离子在一定的工作压力下, 垂直地射向样品表面, 进行物理轰击, 使得反应离子刻蚀具有很好的各向异性。
腐蚀气体的选择
对于多晶硅栅电极的刻蚀,腐蚀气体可用Cl2或SF6,要求对其下层的栅氧化膜具有高的选择比。刻蚀单晶硅的腐蚀气体可用Cl2/SF6或SiCl4/Cl2;刻蚀SiO2的腐蚀气体可用CHF3或CF4/H2;刻蚀Si3N4的腐蚀气体可用CF4/O2、SF6/O2或CH2F2/CHF3/O2;刻蚀Al(或Al-Si-Cu合金)的腐蚀气体可用Cl2、BCl3或SiCl4;刻蚀W的腐蚀气体可用SF6或CF4;刻蚀光刻胶的腐蚀气体可用氧气。
对于石英材料, 可选择气体种类较多, 比如CF4、CF4+ H2、CHF3 等。我们选用CHF3 气体作为石英的腐蚀气体。其反应过程可表示为:CHF3 + e——CHF+2 + F (游离基) + 2e,SiO 2 + 4F SiF4 (气体) + O 2 (气体)。SiO 2 分解出来的氧离子在高压下与CHF+2 基团反应, 生成CO ↑、CO 2↑、H2O ↑、O F↑等多种挥发性气体。[1]
对于锗材料、选用含F 的气体是十分有效的。然而, 当气体成份中含有氢时, 刻蚀将受到严重阻碍, 这是因为氢可以和氟原子结合, 形成稳定的HF, 这种双原子HF 是不参与腐蚀的。实验证明, SF6 气体对Ge 有很好的腐蚀作用。反应过程可表示为:SF6 + e——SF+5 + F (游离基) + 2e,Ge + 4F——GeF4 (挥发性气体)
刻蚀技术的发展
反应离子刻蚀技术是国际上近年来刚刚兴起的先进微电子工艺技术,传统的湿法刻蚀由于其刻蚀的各向同性产生严重的钻蚀, 使得图形刻蚀后的边缘比较粗糙, 要刻蚀3um 以下线宽的图形十分困难。而反应离子刻蚀技术以其优异的各向异性刻蚀特性和可灵活控制的工艺因素, 已经成为刻蚀亚微米精细图形必不可少的工具,比如MYCRO RIE的反应均匀性达到2%。反应离子刻蚀机的技术日趋成熟。

-
一汽 推进L4级自动驾驶技术落地
2025-09-15 08:51:01 查看详情 -
一汽红旗E 推进L4级自动驾驶技术落地
2025-09-15 08:51:01 查看详情 -
沃尔沃宣布将推纯电MPV 全新纯电旗舰SUV技术前瞻
2025-09-15 08:51:01 查看详情 -
吉利星越L 重视核心技术/以节能和新能源车为主
2025-09-15 08:51:01 查看详情 -
吉利豪越新增车型上市 在技术支持和工程服务领域展开合作
2025-09-15 08:51:01 查看详情 -
一汽奔腾规划全新轿车 推进L4级自动驾驶技术落地
2025-09-15 08:51:01 查看详情 -
吉利汽车回复上交所27问 在技术支持和工程服务领域展开合作
2025-09-15 08:51:01 查看详情 -
郎朗喜提沃尔沃XC90 全新纯电旗舰SUV技术前瞻
2025-09-15 08:51:01 查看详情 -
吉利嘉际L将于今晚上市 重视核心技术/以节能和新能源车为主
2025-09-15 08:51:01 查看详情 -
全新沃尔沃S90假想图 全新纯电旗舰SUV技术前瞻
2025-09-15 08:51:01 查看详情


 求购
求购

